Go List
 2024-12-18
2024-12-18英飛凌推出全球最薄矽功率晶圓,突破技術極限並提高能效
來源: 英飛凌官方微信
繼宣佈推出全球首款 300mm 氮化鎵(GaN)功率半導體晶圓和在馬來西亞居林建成全球最大的 200mm 碳化矽(SiC)功率半導體晶圓廠之後,英飛凌再次在半導體製造技術領域取得新的里程碑。英飛凌在處理和加工史上最薄的矽功率晶圓方面取得了突破性進展,這種晶圓直徑為 300mm,厚度為 20μm。厚度僅有頭髮絲的四分之一,是目前最先進的 40-60μm 晶圓厚度的一半。

Jochen Hanebeck / 英飛凌科技首席執行官

這款全球最薄的矽晶圓展現了我們致力於通過推動功率半導體技術的發展,為客戶創造非凡的價值。英飛凌在超薄晶圓技術方面的突破標誌著我們在節能功率解決方案領域邁出了重要一步,並且有助於我們充分發揮全球低碳化和數位化趨勢的潛力。憑藉這項技術突破,英飛凌掌握了 Si、SiC 和 GaN 這三種半導體材料,鞏固了我們在行業創新方面的領先優勢。
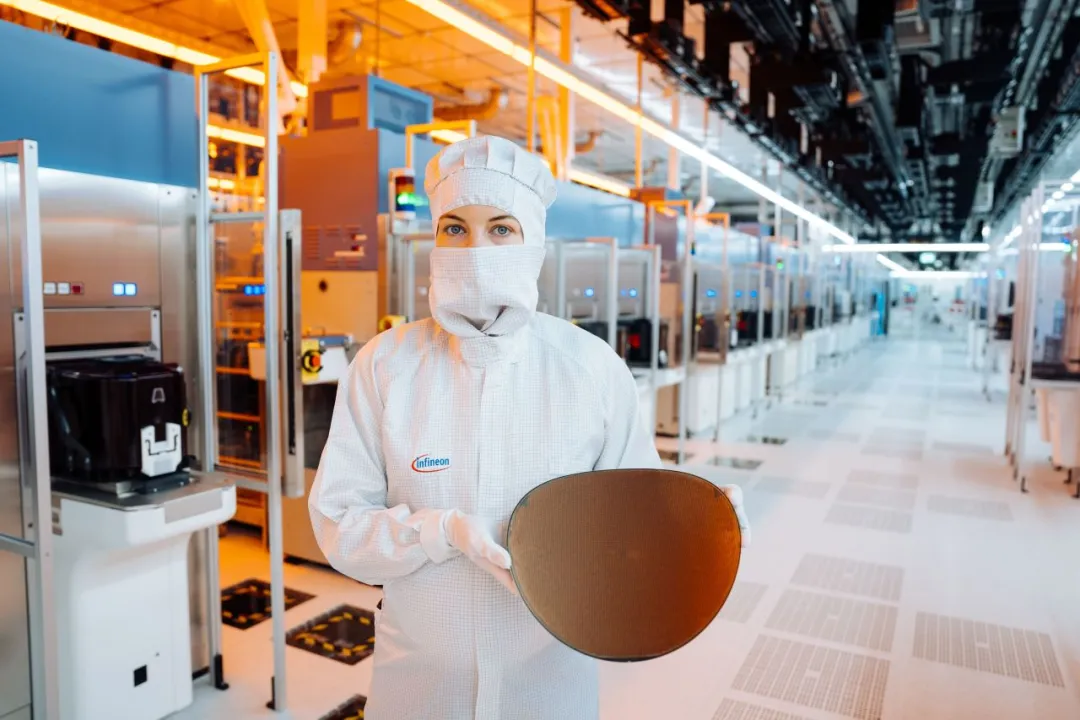
這項創新將有助於大幅提高功率轉換解決方案的能效、功率密度和可靠性,適用於 AI 資料中心,以及消費、電機控制和計算應用。與基於傳統矽晶圓的解決方案相比,晶圓厚度減半可將基板電阻降低 50%,從而使功率系統中的功率損耗減少 15% 以上。對於高端AI伺服器應用來說,電流增大會推動能源需求上升,因此,將電壓從 230V 降低到 1.8V 以下的處理器電壓,對於功率轉換來說尤為重要。超薄晶圓技術大大促進了基於垂直溝槽 MOSFET 技術的垂直功率傳輸設計。這種設計實現了與 AI 晶片處理器的高度緊密連接,在減少功率損耗的同時,提高了整體效率。
Adam White / 英飛凌科技 / 電源與傳感系統事業部總裁

新型超薄晶圓技術推動了我們以最節能的方式為從電網到核心的不同類型的 AI 伺服器配置提供動力的雄心。隨著 AI 資料中心的能源需求大幅上升,能效變得日益重要。這給英飛凌帶來了快速發展的機遇。基於中雙位數的增長率,預計我們的 AI 業務收入在未來兩年內將達到 10 億歐元。
由於將晶片固定在晶圓上的金屬疊層厚度大於 20μm,因此為了克服將晶圓厚度降低至 20μm 的技術障礙,英飛凌的工程師們必須建立一種創新而獨特的晶圓研磨方法。這極大地影響了薄晶圓背面的處理和加工。此外,與技術和生產相關的挑戰,如晶圓翹曲度和晶圓分離,對確保晶圓穩定性和一流穩健性的後端裝配工藝也有重大影響。20μm 薄晶圓工藝以英飛凌現有的製造技術為基礎,確保新技術能夠無縫集成到現有的大批量 Si 生產線中,而不會產生額外的製造複雜性,從而保證盡可能高的產量和供應安全性。
該技術已獲得認可,並被應用于英飛凌的集成智慧功率級(直流 - 直流轉換器)中,且已交付給首批客戶。同時,該技術還擁有與 20μm 晶圓技術相關的強大專利組合,體現了英飛凌在半導體製造領域的創新領先優勢。隨著目前超薄晶圓技術的發展,英飛凌預測在未來三到四年內,現有的傳統晶圓技術將被用於低壓功率轉換器的替代技術所取代。這項突破進一步鞏固了英飛凌在市場上的獨特地位。英飛凌目前擁有全面的產品和技術組合,覆蓋了基於 Si、SiC 和 GaN 的器件,這些器件是推動低碳化和數位化的關鍵因素。
掃描二維碼, 關注英飛凌官方微信尋找更多應用或產品資訊
